Completely automated lithography cluster system allowing batch processing of 6” & 8” Si -wafers. Includes DI rinse, Vacuum Primer for HMDS, resist coater module, developer module, 2 hotplates, 1 cool plate & centering station.
Equipment
Suss Gamma 4M Cluster System
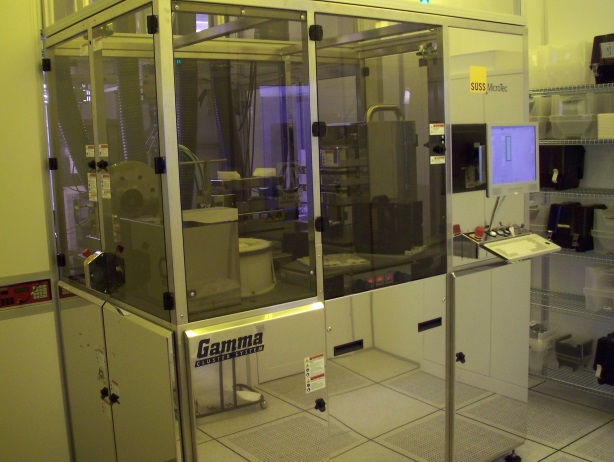
Specifications
Coater Station
- AZ ECI 3012 High Resolution photoresist and AZ 45XX Thick photoresist
- Spin speed range 10-5000 rpm (cover open); 10-3000 rpm (cover closed)
- Spin speed accuracy ± 1 rpm
- Acceleration 10-5000 rpm/s (cover open); 10-4000 rpm (cover closed)
- Lift pin mechanism
- Programmable dispense arm
- Backside Rinse & Frontside EBR
- Nozzle clean
Developer Station
- AZ 726 MIF Developer
- Dispense arm for puddle development
- DI Nozzle for rinsing substrates
- Spin speed range 10-6000rpm
- Acceleration 10-3000 rpm/s
- Programmable dispense arm
- Backside Rinse
Vacuum Primer for HMDS
- Temperature Range 60-200 °C
- Uniformity (up to 120 °C) ± 0.6 °C
- Uniformity (above 120 °C ) ± 1.2 °C
Hotplate Cassette
- Two 250 °C Hotplates
- Temperature Range 60-250 °C
- Uniformity (up to 120 °C) ± 0.5 °C
- Uniformity (from 120 °C to 250 °C) ± 1.0 %
- Programmable Proximity 0.2-15 mm, step 0.1 mm
- Fixed Proximity 0.15 mm
Coolplate Cassette
- Temperature Range 60-250 °C
- Uniformity ± 0.2 °C
- Programmable Proximity 0.2-15 mm, step 0.1 mm
- Fixed Proximity 0.15 mm
Restrictions & Requirements
- Substrate size (max.): 8” / 200 mm
- Substrate size (min.): 6” / 150 mm
- Other substrate restrictions: No thin wafers, No PDMS or other non-soluble photoresist.
- Batch processing: Yes
- Carrier substrate allowed: No
- Manual load/Carrier load: Robot, Cassette to Cassette